새로운 BONDSCALE™시스템, 웨이퍼 본딩 생산성을 대폭 향상
웨이퍼 본딩 및 리소그래피 장비 공급업체인 EV 그룹(이하 EVG)은 완전히 새로워진 자동화 생산 퓨전 본딩 시스템인 ‘BONDSCALE™’을 출시한다고 밝혔다.
BONDSCALE은 더욱 강화된 엣지 정렬 기술을 채용해 기존 퓨전 본딩 플랫폼에 비해 웨이퍼 본딩 생산성을 크게 향상시켰으며, 소유 비용(CoO)도 크게 낮아졌다.
![[#세미콘코리아] EV 그룹, 차세대 퓨전 웨이퍼 본딩 장비 출시 [#세미콘코리아] EV 그룹, 차세대 퓨전 웨이퍼 본딩 장비 출시](https://icnweb.kr/wp-content/uploads/2019/01/EVG_BONDSCALE_Automated_900.jpg)
BONDSCALE은 모놀리식 3D(M3D) 같은 레이어 전이 공정 기술을 활용하는 첨단 공업용 기판 제조 및 3D 통합 방식 등 광범위한 퓨전/분자 웨이퍼 본딩 애플리케이션에 활용될 수 있도록 설계됐다.
EVG의 폴 린드너(Paul Lindner) CTO는 “웨이퍼 본딩 분야의 세계적인 선도기업인 EVG는 고객들이 새로운 반도체 기술을 초기 R&D 단계에서부터 최종 생산단계까지 적용할 수 있도록 하는 데 앞장서 왔다”며, “이번에 새롭게 출시한 BONDSCALE 솔루션은 한층 더 높은 수준의 생산성을 구현함으로써, 무어의 법칙 그 후의 시대를 위한 차세대 로직 및 메모리 디바이스가 지속적으로 추구하는 보다 우수한 성능, 전력 소모, 면적 축소가 가능하게 해주는 첨단 공업용 기판 및 레이어 전이 공정에 대한 증가하는 수요를 충족한다.”고 말했다.
IRDS 로드맵에 따르면, 기생 미세화(parasitic scaling)는 향후 로직 디바이스 성능에 있어서 핵심 구동력이 될 것이며, 새로운 트랜지스터 아키텍처와 재료를 필요로 할 것이다. 또한 IRDS 로드맵은 M3D 같은 새로운 3D 통합 접근법은 기존 2D 반도체를 예컨대 후면 열 발산, N&P 적층, 로직-온-메모리, 클러스터형 기능 적층, beyond-CMOS 채택 등의 3D VLSI로 서서히 전환해 나가는 데 필요할 것으로 밝히고 있다.
오승모 기자 oseam@icnweb.co.kr









![[전문가기고] K-배터리 3사, ‘Beyond EV’ 시장을 향한 기술 초격차 전략 비교 [인터배터리 2026] [전문가기고] K-배터리 3사, ‘Beyond EV’ 시장을 향한 기술 초격차 전략 비교 [인터배터리 2026]](https://icnweb.kr/wp-content/uploads/2026/03/battery-P3-beyond-Battery-web-1024x576.png)
![[심층기획] 피지컬 AI의 심장 ‘이차전지’, 휴머노이드 로봇 혁명 이끈다 [인터배터리 2026] [심층기획] 피지컬 AI의 심장 ‘이차전지’, 휴머노이드 로봇 혁명 이끈다 [인터배터리 2026]](https://icnweb.kr/wp-content/uploads/2026/03/Battery-pack-interB-Phy-AI.png)
![[데스크칼럼] 삼성 2030 AI 자율 공장 로드맵: 자동화를 넘어 ‘자율 제조’의 시대로 [데스크칼럼] 삼성 2030 AI 자율 공장 로드맵: 자동화를 넘어 ‘자율 제조’의 시대로](https://icnweb.kr/wp-content/uploads/2026/03/Gemini_Generated_Image_2030-AI-factory-1024web.jpg)







![[칼럼] 제조업 생존 가르는 EU CRA와 피지컬 AI 보안 전략 [칼럼] 제조업 생존 가르는 EU CRA와 피지컬 AI 보안 전략](https://icnweb.kr/wp-content/uploads/2026/03/CRA-2026-notebookLM-20260326-1024web.png)

![한국요꼬가와전기, 인터배터리 2026서 ‘배터리 자율 제조’ 비전 제시 [인터배터리 2026] 한국요꼬가와전기, 인터배터리 2026서 ‘배터리 자율 제조’ 비전 제시 [인터배터리 2026]](https://icnweb.kr/wp-content/uploads/2026/03/20260311_1604006789830108724224474-1024x576.jpg)



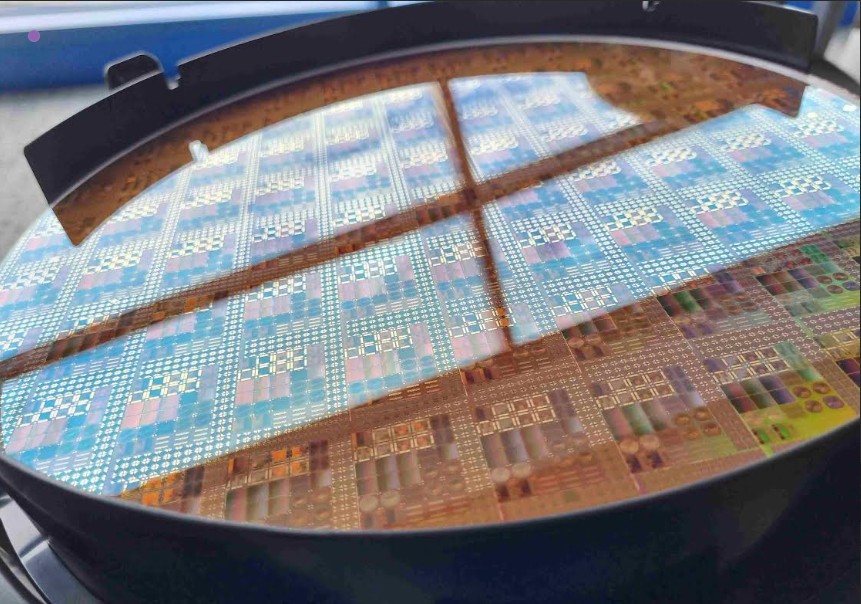
![[그래프] 국회의원 선거 결과 정당별 의석수 (19대-22대) 대한민국 국회의원 선거 결과(정당별 의석 수)](https://icnweb.kr/wp-content/uploads/2025/04/main-image-vote-flo-web-2-324x160.jpg)







