– 노드 제한 없이 필수 배선 씨드층(seed layer)을 증착하는 획기적 방식
반도체, 평판 디스플레이 및 태양전지 장비 글로벌 업체인 어플라이드머티어리얼즈는 반도체 칩상의 수십억 개 트랜지스터(transistors)를 연결하는 인터커넥트(interconnect) 기술의 한계를 극복하기 위한 어플라이드 엔듀라® 엠버™ 물리기상증착(Applied Endura® Amber™ PVD) 시스템을 선보였다.
혁신적인 구리 리플로우 기술(copper reflow technology)이 적용된 이 획기적인 시스템은 1X나노미터(nm) 노드에서 보이드 없이(void-free) 구리 배선 구조를 설계할 수 있다고 입증된 유일한 싱글 챔버(single-chamber) 솔루션이다. 구리 배선 구조 설계 시 발생할 수 있는 보이드(void)는 최첨단 로직 및 메모리 기기 제조공정의 주요 문제로 인식되어 왔다.
어플라이드머티어리얼즈의 MDP(Metal Deposition Products) 사업부 총괄 책임자 겸 부사장인 순다르 라마무르티(Sundar Ramamurthy)는 “어플라이드머티어리얼즈의 리플로우 기술 없이는 높은 수율을 유지하는 동시에 20나노미터 노드 이상에서의 인터커넥트 스케일링을 실현하기가 매우 어렵다.”라고 강조하며, “사실상 어떠한 노드에서도 빠르고 결점 없는 증착을 실현하는 자사 고유의 시스템을 선보임으로써 이러한 문제점을 해결하기 위한 선도적인 PVD 기술을 확장하고 있다.”라고 덧붙였다.
오늘날의 고밀도 마이크로칩(high-density microchips)은 레이어(layers) 간에 60마일 이상의 구리 배선과 100억 개 이상의 수직 접속부(vertical connections) 또는 바이어스(vias)가 있는 복잡한 다층구조의 네트워크이다.
보다 좁고 깊어지는 인터커넥트 구조에 따라 그 숫자는 앞으로도 상당히 증가할 것으로 전망되며, 기존 기술로는 배선구조에 구리를 완벽하고 확실하게 채우기가 매우 어려워졌다. 1X 나노미터 노드에서는 단 하나의 보이드라도 칩에 결함을 일으킬 수 있기 때문에 이러한 문제는 가장 주요하게 해결해야 할 과제로 떠올랐다.
어플라이드머티어리얼즈의 엠버(Amber) 구리 리플로우 기술은 앞서 언급된 문제점들을 이점으로 바꿈으로써 주요 과제를 해결한다. 모세관 작용(capillary action)을 이용함에 따라, 증착된 구리는 심지어 가장 폭이 좁은 배선구조 속으로도 빨려 들어갈 수 있다. 이를 통해 어떠한 반도체 칩(다이, die) 설계 시에도 가장 폭이 좁은 구조부터 넓은 구조까지 빠르고 결점 없는 증착이 가능하다.
어플라이드머티어리얼즈의 엠버 시스템은 성공적으로 업계를 선도했던 엔듀라(Endura) CuBS RFX PVD 시스템의 혁신 기술을 기반으로 하여 만들어졌다. CuBS RFX 시스템의 고유한 선택적 PVD 기술은 오버행(overhang) 없는 정밀한 증착 프로파일(deposition profile)을 제공하며 이는 차후의 리플로우 공정에 필수적이다.
어플라이드머티어리얼즈 www.appliedmaterials.com
아이씨엔 매거진 2012년 08월호









![[전문가기고] K-배터리 3사, ‘Beyond EV’ 시장을 향한 기술 초격차 전략 비교 [인터배터리 2026] [전문가기고] K-배터리 3사, ‘Beyond EV’ 시장을 향한 기술 초격차 전략 비교 [인터배터리 2026]](https://icnweb.kr/wp-content/uploads/2026/03/battery-P3-beyond-Battery-web-1024x576.png)
![[심층기획] 피지컬 AI의 심장 ‘이차전지’, 휴머노이드 로봇 혁명 이끈다 [인터배터리 2026] [심층기획] 피지컬 AI의 심장 ‘이차전지’, 휴머노이드 로봇 혁명 이끈다 [인터배터리 2026]](https://icnweb.kr/wp-content/uploads/2026/03/Battery-pack-interB-Phy-AI.png)
![[데스크칼럼] 삼성 2030 AI 자율 공장 로드맵: 자동화를 넘어 ‘자율 제조’의 시대로 [데스크칼럼] 삼성 2030 AI 자율 공장 로드맵: 자동화를 넘어 ‘자율 제조’의 시대로](https://icnweb.kr/wp-content/uploads/2026/03/Gemini_Generated_Image_2030-AI-factory-1024web.jpg)







![[칼럼] 제조업 생존 가르는 EU CRA와 피지컬 AI 보안 전략 [칼럼] 제조업 생존 가르는 EU CRA와 피지컬 AI 보안 전략](https://icnweb.kr/wp-content/uploads/2026/03/CRA-2026-notebookLM-20260326-1024web.png)

![한국요꼬가와전기, 인터배터리 2026서 ‘배터리 자율 제조’ 비전 제시 [인터배터리 2026] 한국요꼬가와전기, 인터배터리 2026서 ‘배터리 자율 제조’ 비전 제시 [인터배터리 2026]](https://icnweb.kr/wp-content/uploads/2026/03/20260311_1604006789830108724224474-1024x576.jpg)



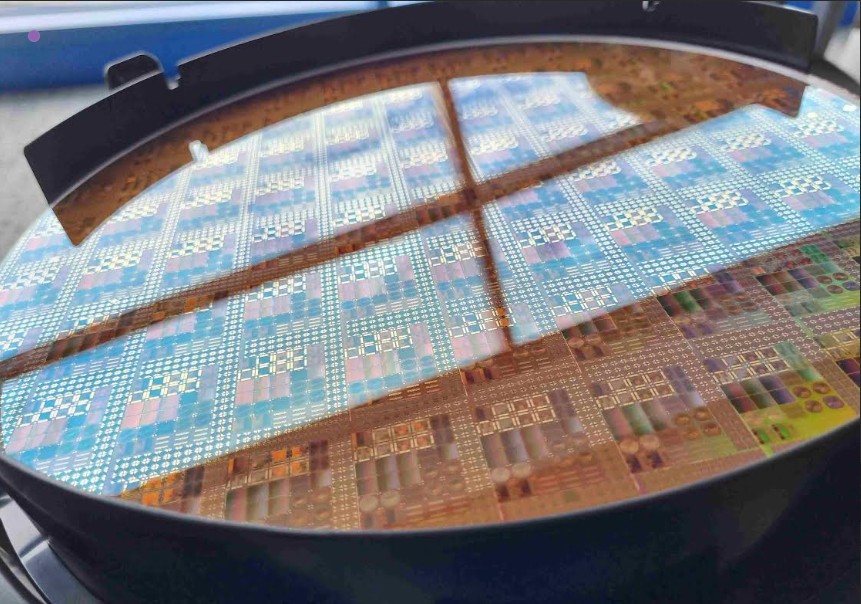
![[그래프] 국회의원 선거 결과 정당별 의석수 (19대-22대) 대한민국 국회의원 선거 결과(정당별 의석 수)](https://icnweb.kr/wp-content/uploads/2025/04/main-image-vote-flo-web-2-324x160.jpg)







